
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
„SiGe in Chip Manufacturing“: profesionalus naujienų pranešimas
Puslaidininkinių medžiagų evoliucija
Šiuolaikinių puslaidininkių technologijų srityje nenumaldomas siekis miniatiūrizuoti išstūmė tradicinių silicio pagrindu pagamintų medžiagų ribas. Siekiant patenkinti didelio našumo ir mažo energijos suvartojimo poreikius, SiGe (silicio germanis) tapo pasirinkta kompozicine medžiaga puslaidininkinių lustų gamyboje dėl savo unikalių fizinių ir elektrinių savybių. Šiame straipsnyje gilinamasi įepitaksijos procesasSiGe ir jo vaidmuo epitaksiniame augime, įtempto silicio taikymuose ir „Gate-All-Around“ (GAA) struktūrose.
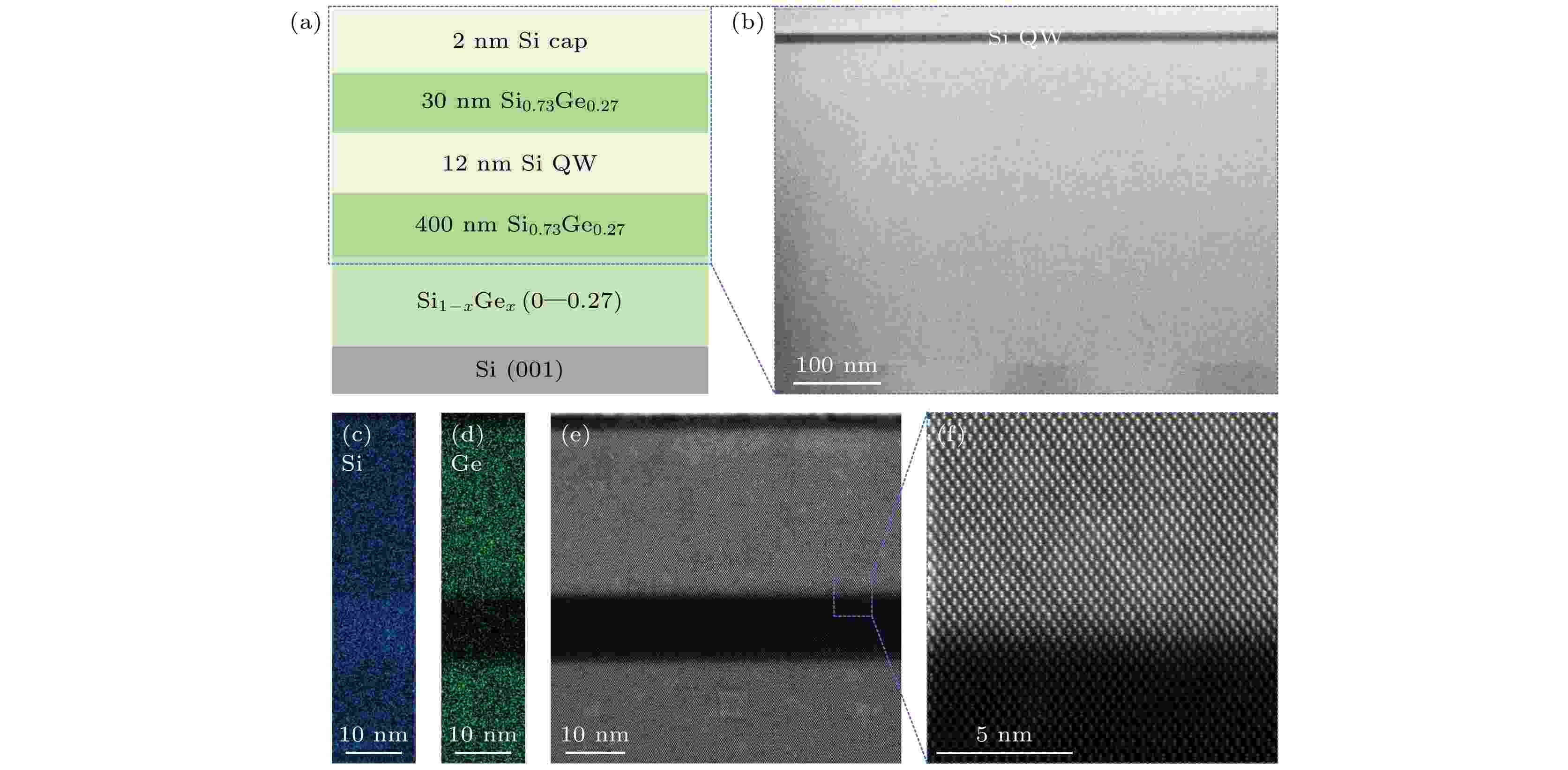
SiGe epitaksijos reikšmė
1.1 Epitaksijos įvadas lustų gamyboje:
Epitaksija, dažnai sutrumpintai vadinama Epi, reiškia vieno kristalo sluoksnio augimą ant vieno kristalo substrato, turinčio tą patį grotelių išdėstymą. Šis sluoksnis gali būti tiekhomoepitaksinis (pvz., Si/Si)arba heteroepitaksiniai (pvz., SiGe/Si arba SiC/Si). Epitaksiniam augimui naudojami įvairūs metodai, įskaitant molekulinio pluošto epitaksiją (MBE), itin aukštą vakuuminį cheminį nusodinimą iš garų (UHV/CVD), atmosferos ir sumažinto slėgio epitaksiją (ATM ir RP Epi). Šiame straipsnyje pagrindinis dėmesys skiriamas silicio (Si) ir silicio-germanio (SiGe) epitaksiniams procesams, plačiai naudojamiems puslaidininkių integrinių grandynų gamyboje su siliciu kaip substrato medžiaga.
1.2 SiGe Epitaxy pranašumai:
Sudėtyje yra tam tikra germanio (Ge) dalisepitaksijos procesassudaro SiGe vieno kristalo sluoksnį, kuris ne tik sumažina juostos plotį, bet ir padidina tranzistoriaus ribinį dažnį (fT). Dėl to jis plačiai taikomas belaidžio ir optinio ryšio aukšto dažnio įrenginiuose. Be to, pažangiuose CMOS integrinių grandynų procesuose gardelės neatitikimas (apie 4%) tarp Ge ir Si sukelia gardelės įtempimą, padidindamas elektronų ar skylių mobilumą ir taip padidindamas įrenginio soties srovę bei atsako greitį.
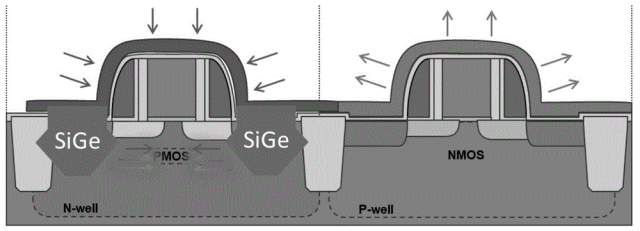
Išsamus „SiGe“ epitaksijos proceso srautas
2.1 Išankstinis apdorojimas:
Silicio plokštelės iš anksto apdorojamos atsižvelgiant į norimus proceso rezultatus, pirmiausia pašalinant natūralų oksido sluoksnį ir nešvarumus nuo plokštelės paviršiaus. Stipriai legiruotų substrato plokštelių atveju labai svarbu apsvarstyti, ar būtinas užpakalinis sandarinimas, siekiant sumažinti automatinį dopingą vėlesnio naudojimo metu.epitaksijos augimas.
2.2 Augimo dujos ir sąlygos:
Silicio dujos: silanas (SiH₄), dichlorsilanas (DCS, SiH₂Cl₂) ir trichlorsilanas (TCS, SiHCl3) yra trys dažniausiai naudojami silicio dujų šaltiniai. SiH₄ tinka žemos temperatūros pilnai epitaksijos procesams, o TCS, žinomas dėl greito augimo greičio, plačiai naudojamas tirštamsilicio epitaksijasluoksnių.
Germanio dujos: Germane (GeH₄) yra pagrindinis germanio įdėjimo šaltinis, naudojamas kartu su silicio šaltiniais SiGe lydiniams formuoti.
Selektyvi epitaksija: selektyvus augimas pasiekiamas koreguojant santykinius rodikliusepitaksinis nusėdimasir in situ ėsdinimas, naudojant chloro turinčias silicio dujas DCS. Selektyvumas atsiranda dėl to, kad Cl atomų adsorbcija ant silicio paviršiaus yra mažesnė nei oksidų ar nitridų, palengvinanti epitaksinį augimą. SiH₄, neturintis Cl atomų ir turintis mažą aktyvinimo energiją, paprastai taikomas tik žemos temperatūros pilniems epitaksijos procesams. Kitas dažniausiai naudojamas silicio šaltinis, TCS, turi žemą garų slėgį ir yra skystas kambario temperatūroje, todėl H₂ reikia burbuliuoti, kad jis patektų į reakcijos kamerą. Tačiau jis yra palyginti nebrangus ir dėl greito augimo greičio (iki 5 μm/min.) dažnai naudojamas storesniems silicio epitaksiniams sluoksniams auginti, plačiai taikomas silicio epitaksinių plokštelių gamyboje.

Įtemptas silicis epitaksiniuose sluoksniuose
Perepitaksinis augimas, epitaksinis vieno kristalo Si yra nusodinamas ant atsipalaidavusio SiGe sluoksnio. Dėl gardelės neatitikimo tarp Si ir SiGe, Si vieno kristalo sluoksnis yra veikiamas tempimo įtempių iš pagrindinio SiGe sluoksnio, žymiai padidindamas elektronų mobilumą NMOS tranzistoriuose. Ši technologija ne tik padidina prisotinimo srovę (Idsat), bet ir pagerina įrenginio atsako greitį. PMOS įrenginiuose SiGe sluoksniai epitaksiškai auginami šaltinio ir nutekėjimo srityse po ėsdinimo, kad kanale būtų įtemptas gniuždomasis įtempis, padidėtų skylių mobilumas ir padidėtų soties srovė.
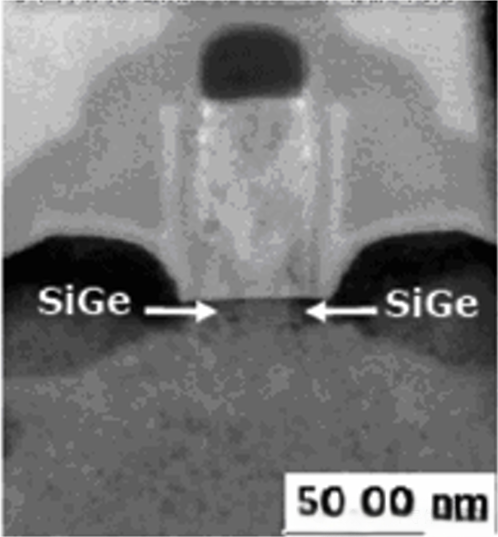
SiGe kaip aukos sluoksnis GAA struktūrose
Gaminant Gate-All-Around (GAA) nanolaidinius tranzistorius, SiGe sluoksniai veikia kaip aukojamieji sluoksniai. Didelio selektyvumo anizotropinio ėsdinimo metodai, tokie kaip kvaziatominio sluoksnio ėsdinimas (kvazi-ALE), leidžia tiksliai pašalinti SiGe sluoksnius, kad susidarytų nanolaidų arba nanoskopų struktūras.
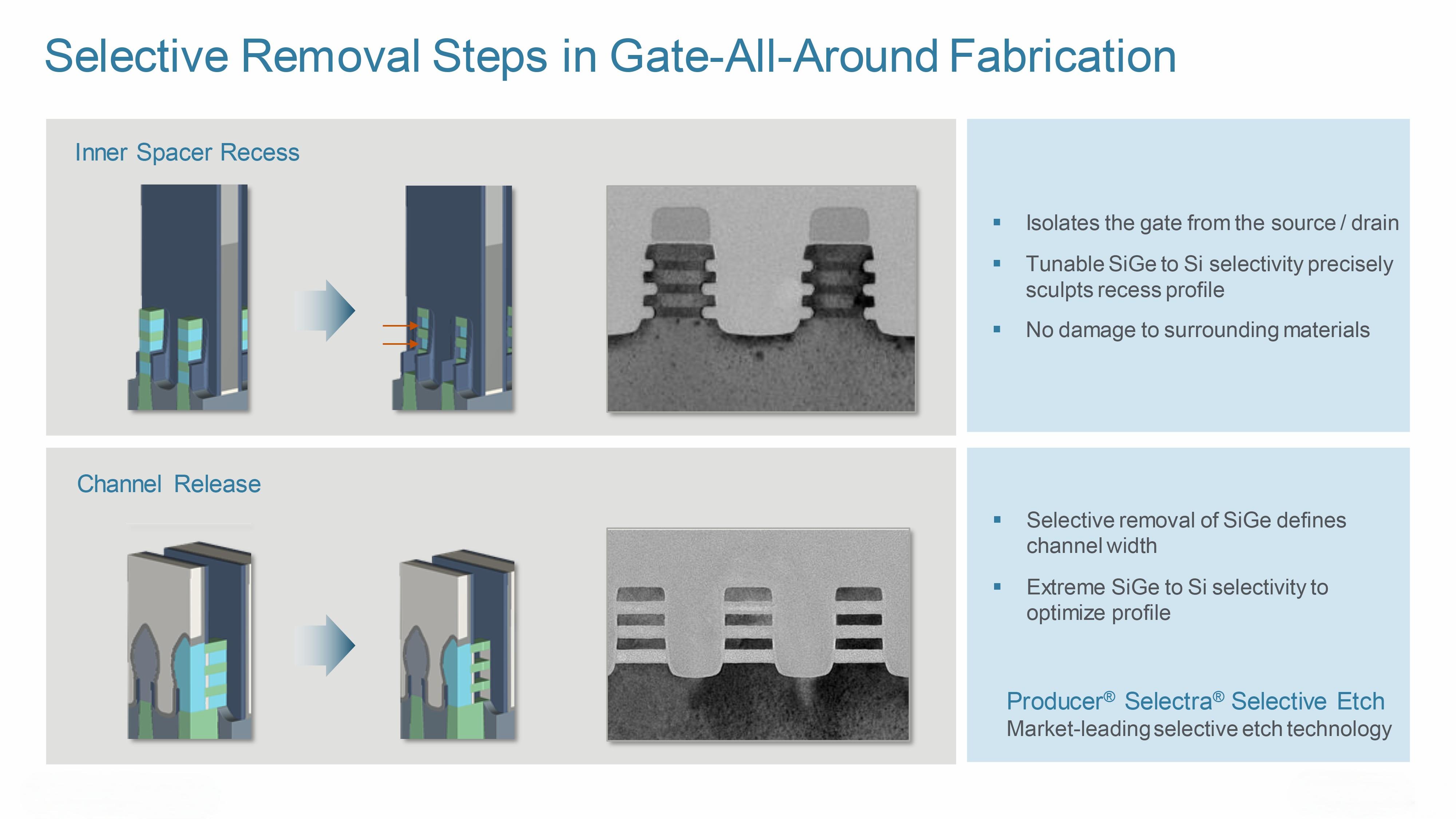
Mes, Semicorex, specializuojamėsSiC/TaC dengti grafito tirpalaiTaikomas Si epitaksiniam augimui puslaidininkių gamyboje, jei turite klausimų ar reikia papildomos informacijos, nedvejodami susisiekite su mumis.
Telefonas pasiteirauti: +86-13567891907
paštas: sales@semicorex.com




